QFN和DFN封裝工藝介紹-KIA MOS管
信息來源:本站 日期:2025-03-25
DFN封裝和QFN封裝都是無引腳表面貼裝封裝結構,具有現代底部排放和頂部嵌入式封裝的特點,它們都具有體積小、易于集成、一致性好、小型化、輕量化和薄型化等優點,它們的底部通常具有較好的導熱性能,能夠有效地散發熱量,提高芯片的可靠性和穩定性能,兩者均有良好的電氣性能,均勻的信號傳輸路徑,低功耗。
DFN封裝和QFN封裝的區別有哪些?
封裝焊盤分布位置不同
DFN封裝的焊盤分布在芯片四周,而QFN封裝的焊盤集中在芯片底部。
焊接結構與底部材料的不同
QFN封裝通常無鉛焊接結構,產品具有更低電感、低容抗等特點。QFN封裝的底部為一般為銅質材料,具有更好的導熱性能和電性能,能夠有效地散發熱量。
封裝的邊長范圍不同
DFN封裝的形狀更加纖薄,常用的寬度通常不到1mm,而QFN封裝的邊長范圍一般在2-7mm之間。
部分應用場景不同
DFN封裝在高頻、高速、高精度等需求市場得到廣泛運用。在5G通信中的天線體,通常使用DFN封裝器件,醫療、工業、汽車等應用的傳感器、照明驅動芯片、打印機傳感器等很多用DFN封裝。
QFN封裝的特性更適用于功率放大器、電池充電管理芯片、自動控制設備類芯片以及娛樂電子產品等,其緊湊的尺寸和高集成度的特性非常實用。
此外,DFN封裝和QFN封裝的形狀有些許差別,DFN封裝通常管腳分布在封裝體兩邊且整體外觀為矩形,而QFN封裝的管腳分布在封裝體四邊且整體外觀為方形。
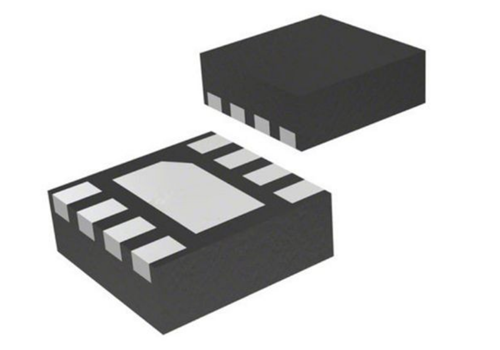

QFN和DFN封裝工藝步驟:
芯片切割:使用劃片機等設備將芯片從硅晶圓上切割分離出來。
芯片貼裝:將切割下來的芯片粘貼到雙框架芯片封裝的基板上。
引腳連接:通過引腳焊盤將芯片的電路與基板的電路進行連接。
模封加工:將雙框架芯片封裝模封在樹脂等材料中,實現防水、防塵等保護。
切邊加工:將雙框架芯片封裝的邊緣進行切割加工,保證封裝的尺寸和形狀符合要求。
QFN和DFN封裝工藝制程流程:
1.基板制備:選擇合適的基板材料,進行表面處理,如防焊處理等。
2.芯片前處理:對芯片進行前處理,包括切割、磨邊、去膠等。
3.焊盤制備:在基板上制備焊盤,常用的方法有電鍍、印刷、噴涂等。
4.芯片定位:將芯片精確定位在基板上,通常采用自動化設備進行精確定位。
5.芯片焊接:將芯片與焊盤進行焊接,常用的方法有熱壓焊、回流焊等。
6.后處理:對焊接后的封裝進行清洗、檢測、包裝等后續處理。
聯系方式:鄒先生
座機:0755-83888366-8022
手機:18123972950(微信同號)
QQ:2880195519
聯系地址:深圳市龍華區英泰科匯廣場2棟1902
搜索微信公眾號:“KIA半導體”或掃碼關注官方微信公眾號
關注官方微信公眾號:提供 MOS管 技術支持
免責聲明:網站部分圖文來源其它出處,如有侵權請聯系刪除。
