半導體封裝工藝流程圖文分享-KIA MOS管
信息來源:本站 日期:2024-06-04
半導體產品的制造過程主要包括前道晶圓制造(Front-End)和后道封裝測試(Back-End),隨著先進封裝技術的滲透,出現了介于晶圓制造和封裝之間的加工環節,稱為中道(Middle-End)。半導體產品的加工工序多,在制造過程中需要大量的半導體設備。在這里,我們介紹傳統封裝(后道)的工藝流程。
塑料封裝是一種傳統封裝方法,分為引線框架封裝和基板封裝。這兩種封裝工藝的前半部分流程相同,而后半部分流程則在引腳連接方式上存在差異。
晶圓經過測試后,首先要經過背面研磨,以達到所需厚度;然后進行晶圓切割,將晶圓切割成芯片;選擇質量良好的芯片,通過芯片貼裝工藝將芯片連接到引線框架或基板上;之后通過引線鍵合的方式實現芯片與基板之間的電氣連接;最后使用環氧樹脂模塑料進行密封保護。引線框架封裝和基板封裝在前半部分流程中均采用上述步驟。
在后半部分流程中,引線框架封裝采用如下步驟:通過切筋的方式將引線分離;通過電鍍將錫球置放至引線末端;最后是成型工藝,成型工藝將封裝分離為獨立單元,并彎曲引線,以便將它們連接到系統板上。而對于基板封裝,則是在進行植球,即錫球被焊接在基板焊盤上之前,先完成模塑;之后進行切割,成為獨立封裝,也可稱之為切單。
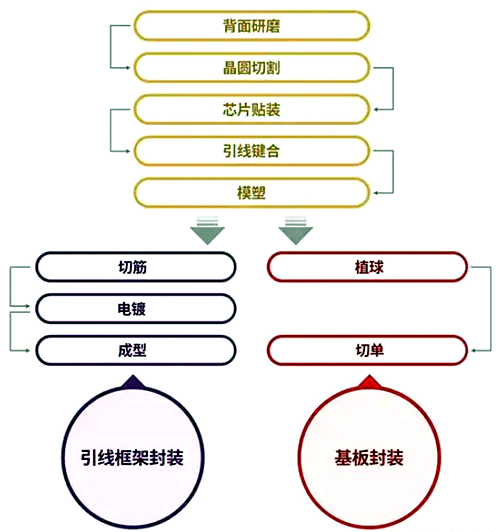
傳統封裝工藝大致可以分為背面減薄、晶圓切割、晶圓貼裝、引線鍵合、塑封、激光打印、切筋成型和成品測試等8個主要步驟。
背面減薄
由于制造工藝的要求,對晶片的尺寸精度、幾何精度、表面潔凈度等都提出很高的要求,因此在幾百道工藝流程中只能采用一定厚度的晶片在工藝過程中傳遞、流片。通常在集成電路封裝前,需要對晶圓背面多余的基體材料去除一定的厚度,這一過程稱之為晶圓背面減薄工藝。
晶圓切割
根據晶圓工藝制程及客戶的產品需求,一片晶圓通常由幾百至數萬顆小芯片組成,業內大部分晶圓上的Dice之間有著40um-100um不等的間隙區分,此間隙被稱為劃片街區(切割道)。而圓片上99%的芯片都具有獨立的性能模塊(1%為邊緣Dice,不具備使用性能),為將小芯片分離成單顆Dice,就需采用切割的工藝進行切割分離,此工藝過程叫做晶圓切割。

晶圓貼裝
晶圓貼裝的目的將切割好的晶圓顆粒用銀膏粘貼在引線框架的晶圓廟上,用粘合劑將已切下來的芯片貼裝到引線框架的中間燥盤上。通常是環氧(或聚酰亞胺)用作為填充物以增加粘合劑的導熱性。
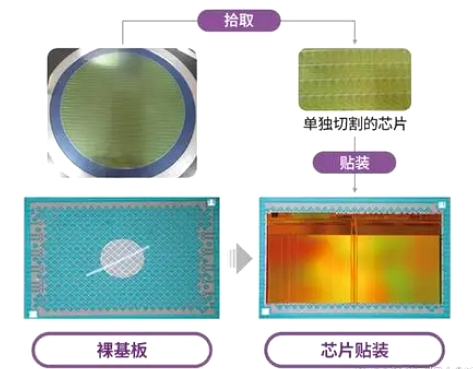
引線鍵合
引線鍵合的目的是將晶圓上的鍵合壓點用極細的金線連接到引線框架上的內引腳上,使得晶圓的電路連接到引腳。通常使用金線的一端燒成小球,再將小球鍵合在第一焊點。然后按照設置好的程序拉金線,將金線鍵合在第二焊點上。
塑封
將完成引線鍵合的芯片與引線框架置于模腔中,再注入塑封化合物環氧樹脂用于包裹住晶圓和引線框架上的金線。這是為了保護晶圓元件和金線。塑封的過程分為加熱注塑、成型兩個階段。塑封的目的主要是:保護元件不受損壞;防止氣體氧化內部芯片;保證產品使用安全和穩定。
激光打印
激光打印是用激光射線的方式在塑封膠表面打印標識和數碼。包括制造商的信息,器件代碼,封裝日期,可以作為識別和可追溯性。
切筋成型
將原來連接在一起的引線框架外管腳切斷分離,并將其彎曲成設計的形狀,但不能破壞環氧樹脂密封狀態,并避免引腳扭曲變形,將切割好的產品裝入料管或托盤便于轉運。
成品測試
檢測產品的外觀是否能符合設計和標準。常見的的測試項目包括:引腳平整性、共面性,引腳間的腳距,塑封體是否損傷、電性能及其它功能測試等。
聯系方式:鄒先生
聯系電話:0755-83888366-8022
手機:18123972950(微信同號)
QQ:2880195519
聯系地址:深圳市福田區金田路3037號金中環國際商務大廈2109
請搜微信公眾號:“KIA半導體”或掃一掃下圖“關注”官方微信公眾號
請“關注”官方微信公眾號:提供 MOS管 技術幫助
免責聲明:本網站部分文章或圖片來源其它出處,如有侵權,請聯系刪除。

